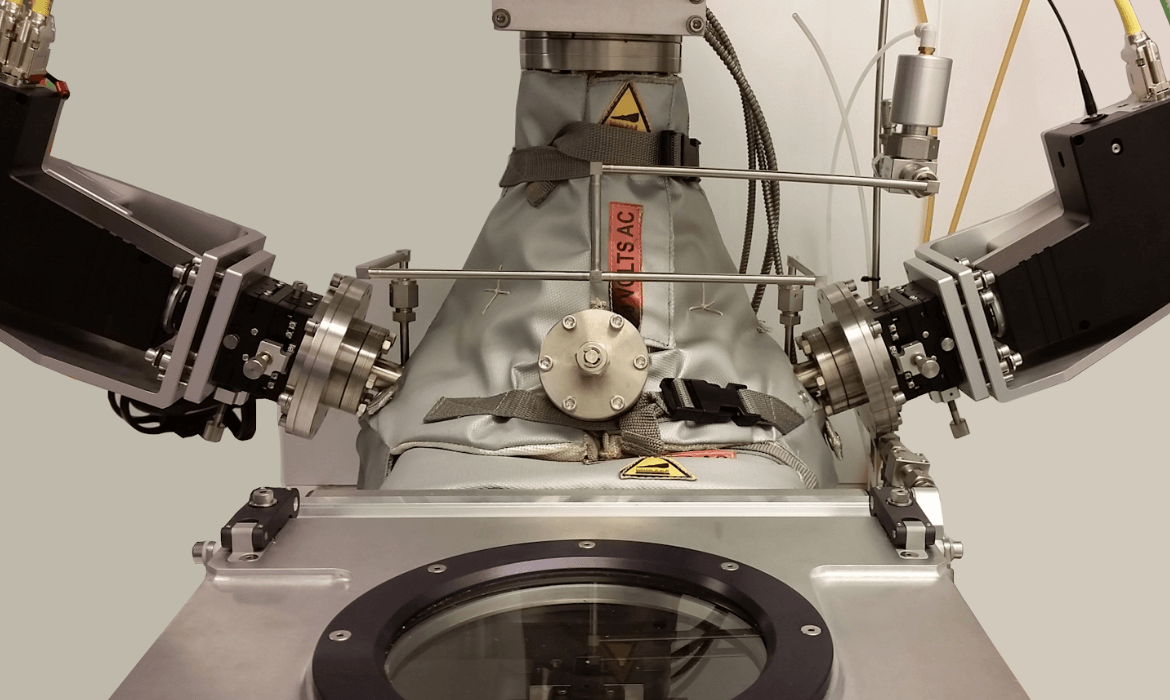
This high-performance, non-contact, non-destructive optical metrology tool provides precise measurement of thin film thickness and optical constants across single and multilayer structures. Designed for R&D labs, universities, and industries like semiconductor, PV and optics, it supports advanced modeling, mapping, and real-time data visualization.